HDI PCB铜电镀工艺指南
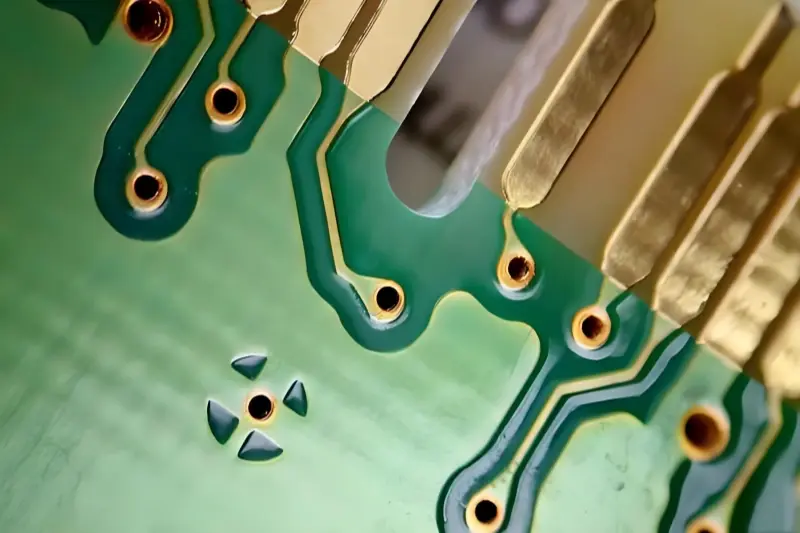
PCB板生产需求及发展趋势
随着PCB板需求的快速增长和行业的快速发展,板上的线宽和线间距越来越小。在这种情况下, PCB制造 技术面临着越来越高的要求。在PCB上通过电镀工艺增加铜层厚度,这只是PCB生产过程中的一个步骤,但却是至关重要的一个步骤。铜层厚度分布的质量、过孔壁上的镀层缺陷以及盲孔和微孔的填充情况,都会直接影响PCB的质量。
同时,电镀前的预处理(包括钻孔和图案转移)以及电镀后的蚀刻和剥离也会影响产品质量。在整个工艺流程中,铜电镀是第一步,其电镀参数必须优化,才能提高整个生产过程的产品质量和后续工序的良率。只有这样才能形成高质量的镀铜层、过孔和盲孔,也只有这样才能保证后续工序中PCB的质量。
传统PCB铜电镀工艺
传统PCB铜电镀工艺分为面板电镀和图案电镀两种。对于高密度互连板(HDI板),无论采用哪种工艺,各有优缺点。
HDI生产中面板电镀的优势
当面板采用电镀工艺时 HDI生产主要优点如下:
- 采用面板电镀工艺制作的电路板,其表面铜层厚度更加均匀。孔内铜层厚度与电镀设备和工艺参数有关。一般来说,采用面板电镀工艺时,这些参数更容易优化。
- 预处理过程中,如果板表面或孔内残留干膜,则干膜残留处将不会镀铜。
- 根据面板电镀层的厚度特征,电镀后下一步更容易调整蚀刻参数。
- 一般来说,面板电镀过程中线路的横截面积变化不大,或者变化很小。这有助于确保蚀刻后的阻抗完全满足产品要求。
面板电镀的缺点
面板电镀也存在自身的问题:
- NDI中的阻抗值取决于图案转移、图案的复杂性和图案电镀工艺。
- 在面板电镀中,镀铜层与基材铜一起被蚀刻,只有线条区域不被蚀刻。这会导致侧面蚀刻、细线缺陷和其他质量问题。对于密集的线条区域,这种情况尤为突出。 HDI 板密集线条的蚀刻速度比孤立线条的蚀刻速度慢,因此很难避免孤立线条的过度蚀刻。
- 面板电镀后的蚀刻过程中,PCB板上大面积的铜会被蚀刻掉,这增加了生产成本。同时,蚀刻后会产生大量的铜离子进入废液,造成环境污染,并增加回收难度。
图案电镀作为面板电镀的替代方案的优势
采用花纹电镀代替面板电镀具有以下优点:
- 图案电镀后,只有底层的铜被蚀刻掉,图案上的铜层不会被蚀刻掉。这可以大大降低侧面蚀刻的风险。
图案电镀作为面板电镀的替代方案的缺点
采用花纹电镀代替面板电镀还有以下缺点:
- 镀层厚度公差取决于图案镀层,因此很难严格满足产品对特性阻抗的要求。
- 在采用图案电镀制作HDI板时,光刻胶(即干膜)必须具有一定的厚度。该厚度主要取决于孔内铜层的厚度。但光刻胶的厚度必须至少大于孔内铜层的厚度。否则,会出现凹陷边缘效应。同时,由于间隙较小,容易出现显影不完全等缺陷,也使得强碱剥离变得困难。这可能导致镀层分离或部分剥离。在后续的蚀刻步骤中,可能会出现断线、缺口和线径变细等缺陷。
- 当采用图案电镀而不是面板电镀时,电镀前图案转移中的宽度和间距公差补偿完全取决于经验。
结合两种工艺弥补各自的不足
为了弥补两种工艺的不足,HDI生产中常用的方法是先进行面板电镀,再进行图案电镀。这样,两种铜电镀工艺的优势得以结合,一种工艺的不足被另一种工艺的优势所弥补。具体细节如下:
- 通过面板电镀法在基底铜上镀上一层薄铜层。这样,在蚀刻过程中,只有基底铜和面板电镀形成的薄铜层会被蚀刻掉。
- 面板电镀和图案电镀中电镀层的厚度可根据实际需要进行调整,这有助于HDI板满足产品质量要求。
- 与仅使用面板电镀或仅使用图案电镀相比,同时使用两种铜电镀工艺可以更容易地优化蚀刻参数。
尽管面板电镀和图案电镀相结合的工艺在HDI生产中具有诸多优势,但仍存在一些局限性,如下:
- 需要蚀刻的铜层仍然比直接在基底铜上进行图案电镀的铜层厚。因此,蚀刻过程中侧面蚀刻仍然很严重。
- 与仅采用面板电镀或图案电镀相比,在HDI生产中同时采用两种铜电镀工艺时,工艺流程更为复杂。这种流程中,出现质量问题和工艺操作问题的可能性更大,最终导致良率降低。
HDI对线宽和线间距提出了更高的要求
为了满足客户对 HDI 板更窄的线宽和线间距的需求,HDI 生产中最重要的一点是:蚀刻后,总铜厚度必须使线宽和线间距达到要求的值。
因此,人们通常在基底铜较薄的电路板上使用图案电镀,其基底铜厚度约为3µm。对于20µm宽的线路,则电镀30µm厚的铜。对于集成电路基板,通常采用以下工艺:在预处理过的基板上沉积0.7至1µm厚的化学铜,然后进行图案转移,再使用图案电镀工艺电镀20至30µm宽的线路,最后进行闪蚀刻。闪蚀刻过程中的工艺控制至关重要,它直接影响最终产品的质量。
无论采用面板电镀、花纹电镀还是面板电镀后接花纹电镀,镀层厚度的均匀性都至关重要。为了满足客户要求,电镀槽必须持续不断地提供电镀所需的铜离子,以保持槽内铜离子浓度在一定范围内稳定。这意味着即使在连续生产过程中,也必须及时向电镀槽中添加铜离子。所采用的方法是使用不溶性磷铜阳极。只有这样才能持续地向电镀槽供应电镀所需的铜离子。这一点可参考文献1进行验证。
由于电镀槽持续工作,前一工序产生的杂质,例如有机污染物,以及设备中的还原性金属(例如铁),都会进入电镀槽。这会导致电镀槽内不同程度的污染,并对产品质量造成潜在风险。为了提高电镀产品的质量,必须对电镀槽进行维护。电镀槽维护包括活性炭处理和电镀槽过滤。过滤和活性炭处理的循环次数与批量生产量相关。然而,不溶性磷铜阳极也存在一些缺点:
- 它们会在阳极表面形成氧化膜。这会导致电解液中有机添加剂的额外消耗,并缩短电解液的使用寿命。
- 电镀液中的气泡可能会影响电路板上微孔铜层的质量,并降低产品的可靠性。
- 对阳极进行氧化维护或对浴槽进行碳处理会增加生产成本。
为确保镀液质量,必须使用高纯水清洗氧化膜,或使用高纯活性炭进行碳化处理。通常,镀液中最常见的污染物是氯离子过量。在正常电镀条件下,氯离子浓度应控制在 40 至 60 mg/L 之间。如果超过此范围,则会导致不良电镀结果。
不过,使用高质量的不溶性磷铜阳极可以减少阳极氧化和碳处理循环的次数,而低质量和廉价的不溶性磷铜阳极则不能。
HDI生产设备特点
由于HDI生产线成本居高不下,在原材料价格(尤其是铜价)持续上涨的情况下,如何提高现有生产线的良率,以及如何在保证产品可靠性、质量和降低成本之间取得平衡,成为HDI生产商面临的一大难题。以下是几个主要方面:
- 电镀形成的镀层厚度应均匀。
- 该设备应具备在薄基底铜板上进行高电流密度电镀的能力,同时保持铜层厚度均匀一致。
- 对于 HDI 通孔、微孔和类似结构,电镀液应具有良好的电镀能力。
- 对于 HDI 通孔、微孔和类似结构,凹槽深度应为同类电镀液中最小的。
- 通过优化设备和电镀电流密度可以提高产量。
- 铜表面不应有任何污染。镀铜表面粗糙度应低,镀液污染也应低。
- 优化后的镀液可将薄芯板上的基底铜厚度保持在 1 至 5 微米以内。
为此,人们开发了卧式电镀生产线。这些生产线不使用标准的磷铜阳极,而是采用分段式阳极分布。这种分布的特点是,不同的电镀段使用不同功率的整流器来提供不同的电流密度。这有助于确保薄铜基底上的镀层均匀一致。
整流系统必须具备提供稳定直流电源的能力,或者具备脉冲电镀能力。与传统的直流电镀相比,脉冲电镀可以提高镀层纯度,降低镀层孔隙率,并改善镀层均匀性。
脉冲电镀是一种调制电流电镀技术。本质上,它是一种间歇式直流电镀,电流的开启和关闭周期以毫秒计。当电流开启时,峰值电流比正常电流高出数倍甚至数十倍。这种瞬时高电流密度使得金属离子在极高的过电位下被还原。因此,镀层具有晶粒细小、密度高、孔隙率低的特点。
当电流关闭或短暂反向时,可以调节镀层周围以及阴极双层内部的镀液。电流的瞬间停止使外部金属离子迅速移动到阴极附近区域,这有助于补充双层中的离子。同时,它还有助于氢或其他杂质脱离并返回镀液,从而提高镀层的纯度并减少氢脆。瞬间反向电流还可以溶解镀层边缘过多的沉积物,从而提高镀层厚度的均匀性。
要使脉冲电镀有效进行,仅仅拥有与工艺参数和电镀槽相匹配的脉冲电源是不够的。还需要更强的过滤、振动,甚至超声波搅拌。这些措施有助于提高传质效率。
电镀层厚度分布均匀性
电镀层厚度分布的均匀性首先取决于所用的电镀设备、电镀工艺以及电镀过程中的参数设置。
在多种优化条件下,对一块尺寸为18英寸×24英寸的薄底铜镀层板进行了测量,该镀层板采用高电流密度水平脉冲电流电镀工艺。测量点分别位于板边夹紧处距板边15毫米和其余两侧距板边10毫米处。结果表明,板表面铜层厚度分布均匀,公差在±10%以内,合格率基本在92%以上。

电镀法盲孔填充
电解沉积填充盲孔已成为电路板行业制造HDI板的标准方法。当采用这种电镀方法填充盲孔时,电流密度必须足够低,以抑制Cu²⁺沉积在微孔外部区域。有关电镀填充盲孔的理论和应用的更多讨论,请参阅参考文献2。
对于HDI生产,电镀工艺必须能够随意填充盲孔,同时又不影响细线。所采用的工艺有两种:面板电镀或图案电镀。
下图所示为采用图案电镀工艺进行通孔填充的集成电路板。在本例中,盲孔填充采用了垂直直流电镀生产线,阳极为不溶性磷铜,并对所有电镀参数进行了优化,从而确保了板面上铜层厚度分布均匀。
对于便携式电子产品和集成电路基板,板面通孔填充并不常用。例如,采用垂直电镀线,以不溶性磷铜阳极为阳极,制备了一块典型的带有通孔微截面的PCB板。电镀电流为1.5 A/dm²。结果表明,垂直电镀线制备的通孔填充效果与电镀盲孔填充效果相当,且盲孔填充质量和表面铜层厚度分布与电镀盲孔填充无明显差异。
如图所示:
- 板材厚度:1.2毫米
- 盲孔直径:0.25 毫米
新工艺:脉冲电镀实现超填充
将原有的水平直流电镀生产线改造为脉冲电镀,并采用合适的电解液参数和特殊的整平添加剂,已成为HDI生产中的一项新工艺。利用这项新工艺对盲孔进行超填充,可将板表面的凹槽深度控制在10µm以内。
检测结果:
- 盲孔直径:170 µm
- 盲孔深度:100 微米
- 表面铜镀层厚度:15 微米
水平脉冲电镀生产线采用强反向脉冲电流密度电镀液,并根据实际生产需求进行充分混合。该电镀液能够使铜均匀沉积在板材表面,满足可靠性要求。
当采用此工艺填充盲孔和通孔时,镀层厚度分布均匀,为 2.5 µm。同时,凹槽深度必须很小。当凹槽深度达到 ±5 µm 时,则不符合高质量产品的要求。
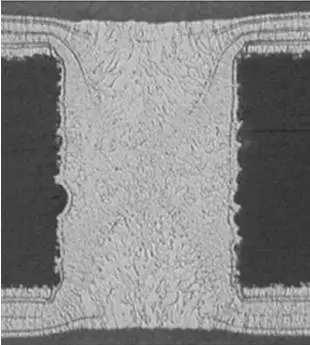
热冲击测试
测试结果表明,采用电镀填充的HDI通孔在封装和制成核心板后能够承受热冲击循环。在某些情况下,例如在基板厚度为60 µm、基底铜厚度为5 µm的电路板上,也可以使用电镀填充直径为100 µm的通孔,以替代传统的盲孔微孔工艺。该工艺与激光钻孔相结合后,可降低生产成本并提高良率。
结语
简而言之,在水平和垂直电镀生产线中使用不溶性磷铜阳极电镀,可以使PCB电镀层满足预期要求。这尤其适用于主要用于便携式电子产品或IC基板产品的HDI板。
该工艺的一个显著优势在于能够持续不断地向电镀液中稳定供应Cu²⁺离子,从而使电镀液中Cu²⁺离子浓度保持在一定水平。这对于长时间的盲孔填充非常有利。
同时,采用水平脉冲电流电镀线,并调整电镀液参数和电镀条件,是一种用于HDI板上通孔超填充的新工艺。该工艺可在15 µm厚的镀层上平滑填充深度小于10 µm的盲孔。此外,该新工艺还能制造线宽和线间距均为50 µm的电路板。采用面板电镀工艺制造的电路板也具有非常均匀的镀层厚度。
研究表明,采用在薄铜基板上进行铜镀覆来制造集成电路基板的半加成工艺已变得非常流行。在整个电路板领域,化学镀铜的主要任务包括:优化化学镀铜液的成分、调整化学镀铜工艺参数、改进化学镀铜前的图案转移、改进化学镀后的盲孔填充,以及优化闪刻参数和电镀过程中使用的光刻胶性能。
常见问题
1. PCB制造中的镀铜工艺是什么?
铜电镀是PCB的关键工艺之一。它在电路板上和过孔内部形成铜层,以确保电气连接和机械强度。
2. 面板电镀和花纹电镀有什么区别?
面板电镀是先在整块电路板上镀上铜,然后再进行蚀刻。图案电镀则只在电路图案上镀铜。每种方法的成本和精度都不同。
3. 为什么微孔填充在HDI PCB中很重要?
微孔填充可提高信号可靠性并降低电阻。对于具有细线和小间距的高密度互连板而言,这一点至关重要。
4. 电镀层厚度如何影响PCB质量?
均匀的铜层厚度可确保稳定的阻抗和信号性能。厚度控制不当会导致缺陷并降低可靠性。
5. 什么是PCB生产中的脉冲电镀?
脉冲电镀采用可控电流循环,可提高铜密度,减少缺陷,并有助于实现更好的均匀性和微孔填充。
6. HDI PCB制造的主要挑战是什么?
主要挑战包括精细线控制、微孔填充质量、铜厚度均匀性和工艺稳定性。
7. 如何提高PCB电镀质量?
通过优化电镀参数、维护电镀液、使用高质量阳极和控制污染,可以提高电镀质量。










