SiPとPCB設計の共進化
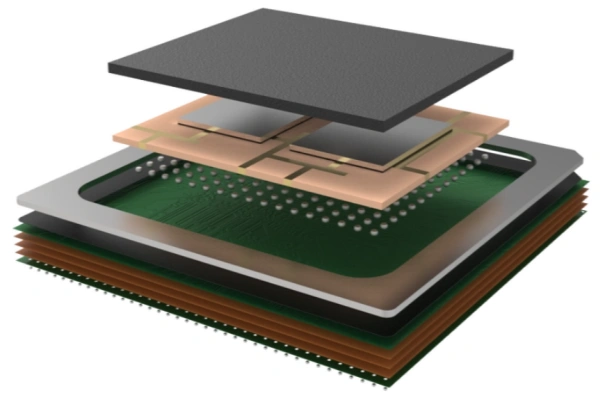
抽象
この記事では、超高密度パッケージング (SiP) と PCB 設計の相乗的な開発について詳しく説明します。統合の重要性について詳しく説明し、プロセスにおける課題と解決策を探り、成功したアプリケーション事例を紹介します。トレンドと展望を分析することで、この相乗効果が現代のエレクトロニクスの進歩に果たす重要な役割を強調し、関連分野の専門家に貴重な洞察を提供することを目指しています。
はじめに
1.1背景
近年、エレクトロニクス業界では小型化と多機能化への顕著な傾向が見られます。モノのインターネット (IoT)、5G 通信、ウェアラブル デバイス、人工知能などの技術の継続的な進歩により、消費者はよりコンパクトで強力、かつ機能豊富な電子製品を求めています。これにより、電子システムの複雑さが大幅に増加し、従来のプリント基板 (PCB) 設計とパッケージング技術に新たな課題が生じています。

超高密度パッケージング、特にシステムインパッケージ (SiP) は、これらの要求を満たすための重要なソリューションとして登場しました。SiP は、複数のチップ、受動部品、さらにはマイクロエレクトロメカニカルシステム (MEMS) を 1 つのパッケージに統合し、高度な機能統合を実現します。これにより、コンポーネント間の相互接続が短縮され、信号伝播遅延が短縮され、システム全体のパフォーマンスが向上します。ただし、SiP の実装が成功するかどうかは、PCB 設計とのシームレスな連携に大きく依存します。PCB は、さまざまなコンポーネントを実装および相互接続するための基盤として機能し、高密度パッケージングの利点を十分に実現するには、その設計を SiP と組み合わせて最適化する必要があります。
1.2の目的
この記事の目的は、SiP と PCB 設計の相乗的な発展を探ることです。この分野の最新技術、課題、およびソリューションを分析することで、電子機器製造業界の専門家に貴重な洞察を提供したいと考えています。SiP と PCB 設計の関係を理解し、それらが連携して技術的なハードルを克服する方法を理解することは、イノベーションを推進し、電子製品の競争力を向上させるために不可欠です。また、電子機器製造のこの重要な側面の継続的な進化を促進するためのさらなる研究開発努力を促すことを目的として、いくつかの成功したアプリケーション事例を紹介し、将来の傾向についても説明します。
2. SiPテクノロジーの理解
2.1 定義とアーキテクチャ
国際半導体技術ロードマップ (ITRS) の定義によると、システムインパッケージ (SiP) とは、さまざまな機能を持つ複数のアクティブ電子部品、オプションのパッシブデバイス、およびマイクロエレクトロメカニカルシステム (MEMS) や光学デバイスなどのその他のコンポーネントを 1 つの標準パッケージに統合してシステムまたはサブシステムを形成することを指します。アーキテクチャ的には、SiP はプロセッサ、メモリ、その他のコンポーネントを含むさまざまな機能チップを 1 つのパッケージに統合して、実質的に完全な機能を実現します。
設計を通じて必要なすべてのコンポーネントを単一のダイに統合するシステムオンチップ (SoC) とは対照的に、SiP は異なるアプローチを採用しています。異なるプロセスとテクノロジを使用して製造されたチップの組み合わせが可能です。たとえば、SiP モジュールには、計算能力を確保するために高度な CMOS テクノロジで製造された高性能プロセッサ チップと、データの保存と取得に最適化された専用メモリ チップが組み込まれている場合があります。これらのチップは、アプリケーションの特定の要件に応じて、横に並べて配置することも、積み重ねて配置することもできます。アーキテクチャのこの柔軟性により、SiP は、特に異種コンポーネントの統合と異なる製造プロセスへの対応に関して、SoC が直面するいくつかの制限を克服できます。

2.2 SiPの利点
SiP の最も重要な利点の 1 つは、開発サイクルが短いことです。統合コンポーネントごとに大規模な設計と検証作業が必要な SoC とは異なり、SiP では既存の検証済みチップを活用します。つまり、メーカーは必要なコンポーネントを迅速に組み立ててパッケージ化し、タイムリーに市場の需要を満たすことができます。たとえば、製品のライフサイクルが短く、新機能を迅速に導入する必要がある、変化の激しい消費者向け電子機器市場では、SiP により、企業は革新的な製品を数年ではなく数か月で市場に投入できます。
SiP は、機能統合も強化します。複数のチップと受動部品を組み合わせることで、コンパクトなパッケージ内で包括的な機能セットを提供できます。ウェアラブル健康モニタリング デバイスを考えてみましょう。SiP モジュールには、データ処理用のマイクロコントローラ、心拍数や血圧などのバイタル サインを監視するセンサー、データをスマートフォンやクラウド サーバーに送信するためのワイヤレス通信チップを統合できます。このレベルの統合により、スペースが節約されるだけでなく、システム全体のパフォーマンスと信頼性が向上します。
さらに、SiP は消費電力の低減にも貢献します。従来の PCB ベースの設計に比べてコンポーネント間の相互接続が短くなるため、信号伝播の遅延が短縮され、伝送中の電力損失が最小限に抑えられます。スマートフォン、スマートウォッチ、IoT センサーなどのバッテリー駆動デバイスでは、これによりバッテリー寿命が大幅に延長され、ユーザー エクスペリエンスが向上し、頻繁な充電の必要性が軽減されます。
2.3 SiPパッケージングプロセス
SiP パッケージングでは、主にワイヤボンディングとフリップチップボンディングという 2 つの主要プロセスが採用されています。
ワイヤボンディングは、確立された広く使用されている技術です。このプロセスは、ウェハの薄化から始まります。ウェハの厚さを元の値からパッケージングに適したレベルまで減らします。これは通常、機械研磨または化学機械研磨 (CMP) によって実現されます。次に、精密鋸引きまたはレーザー切断技術を使用して、ウェハを個々のチップに切断します。チップが得られたら、基板に接着します。接着材料は、Pb-Sn 合金や Au-Si 共晶合金などの軟質はんだ、またはプラスチックパッケージの場合はポリマー接着剤など、さまざまです。チップボンディングの後、通常は金製の細いワイヤを使用して、チップパッドと基板パッド間の電気接続を確立します。ワイヤの直径は通常 0.025mm ~ 0.032mm の範囲で、長さとアークの高さは信頼性の高い接続を確保するために慎重に制御されます。主要なボンディング技術には、熱圧着ボンディングと熱超音波ボンディングがあり、それぞれにボンドの形成と温度制御の点で独自の利点があります。

#image_title
一方、フリップチップ ボンディングには、相互接続密度が高く、電気的性能が優れているという点で、いくつかの利点があります。このプロセスでは、チップを上下逆にし、はんだバンプをチップ パッド上に形成します。次に、これらのバンプを位置合わせしてリフローし、基板上の対応するパッドと直接電気的に接続します。フリップチップ プロセスの前に、ウェハーは、チップの I/O レイアウトを最適化するために、再配線層 (RDL) 形成などの追加の処理手順を経ることがよくあります。はんだバンプの材料とサイズは、信頼性の高い機械的および電気的接続を確保するために慎重に選択されます。ワイヤ ボンディングと比較して、フリップチップ ボンディングでは相互接続の長さが短くなるため、寄生インダクタンスと容量が低くなります。これは、高速デジタルおよび RF アプリケーションにとって非常に重要です。
3. PCB設計の基本
3.1 レイヤーとその機能
一般的な PCB は複数の層で構成され、それぞれが特定の目的を果たします。信号層は主にコンポーネント間の電気信号のルーティングを担当します。これらの層は信号干渉を最小限に抑え、適切な信号整合性を確保するように慎重に設計されています。たとえば、高速デジタル回路では、接続されたコンポーネントのインピーダンスを一致させるために、信号層でインピーダンス制御トレースがよく使用され、信号反射が低減され、伝送信号の品質が維持されます。
電源プレーンとグランドプレーンは、安定した電力分配と信号の低インピーダンス リターン パスを提供する上で重要な役割を果たします。これらは、電源ノイズと電磁干渉 (EMI) の低減に役立ちます。多層 PCB では、専用の内部電源プレーンとグランドプレーンを使用して、ボード全体に均等に電力を分配します。たとえば、デスクトップ コンピューターのマザーボードでは、複数の電源プレーンを使用して CPU、グラフィック カード、メモリ モジュールなどのさまざまなコンポーネントに異なる電圧を供給し、グランドプレーンはすべての信号に共通のリファレンスを提供します。
はんだマスク層は、はんだ付けしてはいけない領域を覆うことで PCB 上の銅トレースを保護し、ショートを防止するために適用されます。また、コンポーネントのはんだ付け可能な領域を定義するのにも役立ちます。一方、シルクスクリーン層には、組み立てやデバッグのプロセスに役立つマーキング、コンポーネント指定子、その他の参照情報が含まれています。これにより、技術者は製造やメンテナンス中に各コンポーネントの位置と方向を簡単に識別できます。
3.2設計上の考慮事項
レイアウト段階では、コンポーネントを戦略的に配置する必要があります。高出力コンポーネントは、熱や電気干渉を避けるために、敏感なコンポーネントから離して配置する必要があります。たとえば、パワーアンプ回路では、熱ノイズによる信号品質の低下を防ぐために、大量の熱を発生するパワートランジスタを低ノイズアンプ段から離れた場所に配置します。関連するコンポーネントをグループ化すると、配線も簡素化され、回路全体のパフォーマンスが向上します。マイクロコントローラベースのシステムでは、マイクロコントローラ、コンデンサや抵抗器などの関連する受動コンポーネント、および外部インターフェイスのコネクタが特定の領域にグループ化されることが多く、トレース長と信号伝播遅延を最小限に抑えます。
ルーティングには、コンポーネント間の電気接続のパスを決定することが含まれます。高速信号では、クロストークやインピーダンスの不一致などの信号整合性の問題を防ぐために、慎重に検討する必要があります。差動ペアは、高速データ伝送によく使用され、2 つのトレースが、制御されたインピーダンスと等しい長さで近接してルーティングされ、ノイズのピックアップを最小限に抑え、信号のバランスを維持します。電源トレースとグランド トレースは、電流要件に対応できる十分な幅が必要です。通常、幅は、抵抗損失と電圧降下を減らすために、予想される電流負荷に基づいて計算されます。
熱管理は、特に高出力アプリケーションでは不可欠です。ヒートシンク、ビア、サーマルパッドを PCB 設計に組み込むことで、熱を効果的に放散できます。たとえば、グラフィックス カードの PCB では、大きな銅領域と複数のビアを使用して、GPU チップからボードに取り付けられた金属ヒートシンクに熱を伝導します。さらに、放熱を強化し、コンポーネントの故障や信頼性の低下につながる過熱を防ぐために、システム全体の設計で適切なエアフロー チャネルを考慮する必要があります。
4. 共生関係
4.1 SiP の PCB 設計への影響
4.1.1 ボードの複雑さを軽減する
トゥルーワイヤレスステレオ(TWS)イヤホンを例に挙げてみましょう。これまで、TWSイヤホンのPCBには、Bluetoothチップ、オーディオコーデック、電源管理IC、さまざまな受動部品など、多数の個別部品を収容する必要がありました。これにより、相互接続の複雑な網と多数のはんだ接合部が発生し、製造上の欠陥や信号干渉のリスクが高まりました。SiP技術の採用により、複数のチップと受動部品が50つのモジュールに統合されます。たとえば、TWSイヤホン用のSiPモジュールには、Bluetooth通信、オーディオ処理、電源管理の機能を組み合わせたBluetoothオーディオSoCを統合できます。これにより、PCB上の部品数が大幅に削減され、回路レイアウトが簡素化されます。その結果、PCB上で接続する必要があるノードの数が大幅に削減されます。一部の高度なTWSイヤホン設計では、機能をSiPに統合した後、PCB上のノード数がXNUMX%以上削減され、数十からわずか数個の重要な接続ポイントになります。これにより、生産サイクルが短縮されるだけでなく、製品の全体的な信頼性も向上します。

4.1.2 小型化の実現
SiP 技術は、PCB ベースの製品の小型化を実現する上で重要な役割を果たします。今日の消費者向け電子機器市場では、スマートウォッチ、フィットネス トラッカー、IoT センサーなどの製品が、より小型のフォーム ファクターに向けて絶えず進化しています。SiP の統合機能により、複数の機能をコンパクトなパッケージに集約できます。マイクロプロセッサ、メモリ、センサー インターフェイス、ワイヤレス通信モジュールなどのコンポーネントを統合する必要があるスマートウォッチを考えてみましょう。SiP を使用すると、これらのコンポーネントを小さなスペース内に高度に統合された方法で積み重ねたり配置したりできます。これにより、PCB 上のコンポーネントが占める領域が削減されます。たとえば、従来の個別コンポーネント設計と比較して、SiP を使用すると、一部のスマートウォッチ アプリケーションで PCB 領域を 30%~50% 削減できます。その結果、製品全体のサイズをさらに縮小でき、携帯性と装着性に対する市場の需要を満たすことができます。

4.1.3 信号整合性要件の変更
SiP 内にコンポーネントを統合すると、従来の PCB 設計と比較して、信号の送受信方法が変わります。SiP では、チップ間の相互接続がはるかに短くなるため、信号伝播遅延と寄生効果を減らすことができます。ただし、これにより、信号の整合性に新たな課題も生じます。たとえば、高速デジタル回路では、インピーダンス整合の要件がより重要になります。SiP 内の信号はより短い距離を移動するため、インピーダンスの不整合があると、重大な信号反射と劣化につながる可能性があります。さらに、SiP 内の異なる機能ブロックが近接していると、クロストークの問題が発生する可能性があります。SiP に統合された RF 回路の場合、適切な信号送受信を確実に行うには、アンテナと他のコンポーネント間の結合を慎重に検討する必要があります。PCB 設計者は、これらの要素を考慮し、制御されたインピーダンス ルーティング、差動ペア、シールドなどの手法を使用して信号の整合性を維持する必要があります。たとえば、5G モバイル フォン SiP モジュールでは、PCB 設計者は、高速データ伝送をサポートするために、RF トレースのインピーダンスが狭い許容範囲内で正確に制御されていることを確認する必要があります。
4.2 SiP 向け PCB 設計の適応
4.2.1 レイアウトの最適化
SiP モジュールを効果的に収容するには、PCB のレイアウトを慎重に最適化する必要があります。まず、SiP モジュールの PCB 上の位置は、その機能と放熱要件に基づいて決定する必要があります。たとえば、SiP に高出力プロセッサが含まれている場合は、ヒートシンクの近くや十分な空気の流れがある位置など、放熱性に優れた領域に配置する必要があります。次に、SiP 周辺の他のコンポーネントのレイアウトを調整する必要があります。デカップリング コンデンサなどの関連する受動コンポーネントは、SiP の対応するピンにできるだけ近づけて配置し、電源トレースとグランド トレースの長さを短縮し、寄生インダクタンスを最小限に抑える必要があります。さまざまな機能の複数の SiP モジュールを組み込んだデスクトップ コンピューターのマザーボード設計では、レイアウトを慎重に計画して、SiP モジュールとメモリ モジュールや拡張スロットなどの他のコンポーネント間のデータ伝送パスができるだけ短くなるようにし、システム全体のパフォーマンスを向上させます。
4.2.2 ルーティングの考慮事項
SiP が存在する場合の PCB 上の配線には特別な注意が必要です。SiP のピン配置によって、最初の配線パスが決まります。クロストークを回避するために、高速信号はノイズの多いコンポーネントや電源トレースから離して配線する必要があります。たとえば、高解像度のビデオ処理デバイスの PCB では、SiP からディスプレイ インターフェイスにビデオ信号を送信するために使用される差動ペアは、信号のバランスと整合性を維持するために慎重に配線されます。これらの差動ペアの長さを一致させることは重要であり、通常、スキューを防ぐために数ミリメートル以内の許容誤差が必要です。さらに、SiP の電源およびグランド配線は、電流要件に対応できるように設計する必要があります。電源の低インピーダンス パスを確保して電圧降下を減らすために、広い電源プレーンと複数のビアがよく使用されます。大量の電力を消費するサーバー マザーボード内の SiP モジュールの場合、電源トレースは通常のトレースよりも数倍広く設計され、ビアを介して複数の層の電源プレーンに接続されて、安定した電力供給が確保されます。
4.2.3 熱管理
SiP モジュール、特に高出力コンポーネントを搭載したモジュールは、大量の熱を発生します。そのため、PCB 設計には効果的な熱管理対策を組み込む必要があります。一般的な方法の 1 つは、サーマル ビアを使用することです。これらのビアは熱伝導性材料で満たされ、PCB 上の発熱コンポーネントをグランドまたはヒートシンク層に接続します。グラフィックス カードの PCB では、熱を逃がすために GPU SiP モジュールの周囲に数十個のサーマル ビアが使用されることがよくあります。別の方法は、PCB 上でサーマル パッドまたはヒート スプレッダーを使用することです。銅やグラファイトなどの熱伝導率の高い材料で作られたサーマル パッドを SiP と PCB の間に配置して、熱伝達を強化します。さらに、PCB 全体のレイアウトでは、熱が発生する領域に冷気が流れるように、気流の方向を考慮する必要があります。コンピューター シャーシの設計では、PCB の位置と方向が冷却ファンと連携するように最適化されているため、熱気が効率的に排出され、必要なコンポーネントに冷気が供給されます。

5. 今後の動向
5.1 SiP技術の進歩
SiP 技術の将来は大きな期待が寄せられています。より多様なコンポーネントが 1 つのパッケージに組み込まれ、さらに高度な統合が実現すると予想されます。たとえば、バイオメディカル アプリケーションの分野では、SiP モジュールにサンプル処理用のマイクロ流体チップ、特定のバイオマーカーを検出するためのバイオセンサー、リアルタイム分析用の信号処理チップを統合できます。これにより、機能が強化されたコンパクトでポータブルな診断デバイスの開発が可能になります。
パフォーマンスの向上も重要な焦点となります。特に、デバイスがバッテリー駆動で、頻繁に充電せずに長時間動作する必要がある IoT (モノのインターネット) などの新しいアプリケーションでは、消費電力をさらに削減することが極めて重要になります。高速データ転送の需要を満たすために、より微細なピッチとより高い帯域幅を備えたシリコン インターポーザーなどの新しい相互接続技術が開発されます。たとえば、5G および将来の 6G 通信システムでは、非常に高い周波数で送受信される膨大な量のデータを処理するために、高度な相互接続を備えた SiP モジュールが不可欠です。
5.2 PCB設計の進化
PCB 設計は、今後も並行して進化していきます。高密度設計が標準となり、集積回路の複雑さの増大に対応するために、トレース幅が狭くなり、ビアが小さくなります。データ センターやスーパーコンピュータなどの高性能コンピューティング アプリケーションでは、PCB は信号損失とクロストークを最小限に抑えながら、極めて高速な信号をサポートする必要があります。そのためには、より優れた誘電特性を持つ高度な材料を使用し、正確なインピーダンス制御を実現する製造プロセスの改善が必要になります。
フレキシブル PCB は、特にウェアラブルおよびフレキシブル エレクトロニクスで、ますます重要になります。これらの PCB はさまざまな形状に適合し、設計の柔軟性が向上します。たとえば、スマート ウェアや埋め込み型医療機器では、フレキシブル PCB をシームレスに統合できるため、快適に着用でき、ユーザーの日常活動への影響を最小限に抑えた革新的な製品の開発が可能になります。さらに、埋め込みパッシブと呼ばれるパッシブ コンポーネントを PCB 基板に直接統合することで、全体的なコンポーネント数が減り、PCB レイアウトがさらに小型化されます。
5.3 継続的な相乗効果
SiP と PCB 設計の継続的な相乗効果は、将来の電子製品の革新の原動力となるでしょう。両方の技術が進歩するにつれて、メーカーはより高度でコンパクトなシステムを作成できるようになります。たとえば、自動車業界では、エンジン制御、運転支援システム、インフォテインメント用の高度な SiP モジュールと最適化された PCB 設計を組み合わせることで、よりスマートでエネルギー効率の高い自動車が実現します。
この相乗効果により、新たな応用分野も開拓されます。宇宙探査の分野では、小型衛星や宇宙船は、SiP の高密度統合と PCB 設計による信頼性の高い相互接続の恩恵を受けることができます。これらの技術により、コストを抑えながら複雑なミッションを遂行できる軽量で高性能な宇宙システムの開発が可能になります。全体として、SiP と PCB 設計の共同開発は、エレクトロニクス業界の未来を形作り、より小型で高速でインテリジェントな電子機器の新時代をもたらすことになります。
6. 結論
結論として、SiP と PCB 設計の相乗的な発展はすでに顕著な成果を達成しています。SiP 技術は、高集積、短い開発サイクル、低消費電力という利点を備えており、電子製品の設計と製造に革命的な変化をもたらしました。現代の電子機器の小型化と多機能化の課題に効果的に対処してきました。一方、PCB 設計は、SiP モジュールに対応するために継続的に適応、進化し、レイアウト、ルーティング、熱管理を最適化して、SiP の可能性を最大限に引き出しています。
民生用電子機器、ウェアラブルデバイス、その他の分野での成功した応用事例を通じて、私たちはこの相乗効果がもたらす大きな価値と競争力を目の当たりにしてきました。しかし、信号干渉、熱問題、設計標準化などの課題は依然として残っています。これらのハードルを克服するには、材料、プロセス、設計方法論の継続的な革新が必要です。
将来を見据えると、SiP と PCB 設計の将来はさらに大きな期待が寄せられています。SiP 技術の進歩により、より高度な統合と優れたパフォーマンスが可能になり、PCB 設計は高密度と柔軟性に向けて進化しており、この 2 つは今後も連携して機能し続けるでしょう。この継続的な相乗効果は、既存のアプリケーション領域における電子製品の革新を推進するだけでなく、新興分野に新たな可能性を切り開きます。次世代のより小型で高速でインテリジェントな電子デバイスを形成する上で重要な役割を果たし、電子産業全体の発展をさらに推進します。関連分野の専門家は、これらのトレンドを注意深く監視し、このダイナミックな技術進化の最前線に留まるために、研究開発に積極的に取り組む必要があります。









